MEMS Product
mems product
mems product Fab. Infrastructure
- All class 1000 clean room. (Class 100 @ PHOTO bay)
- Manufacturing equipment.
- Aligner, Electro Plate Bath, Sputter, Polisher, etc.
- Analysis equipment.
- FE-SEM, ICP, CVS, etc
- Measuring & Inspection equipment.
- 3D Vision, Alpha step, AOI, etc.
- Ceramic, Glass, Silicon wafers are possible.
- from 4” to 12” available.
mems product MEMS Process

-
Thin Film
Able to make sub-micron thin film by Sputter or PECVD.
-
Photo
i-line & Broad band 1X Aligner.
Back & Front side align.
4”, 8”, 12” Process.


-
Electro Plating
EP bath for Ni, Ni alloy, Au, Cu, Sn, Rh.
-
CMP
Polishing process for Ceramic & Silicon wafers.
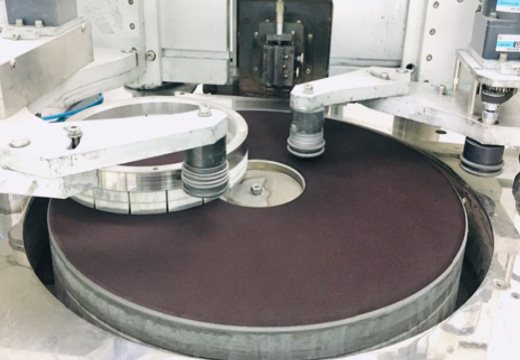

-
ETCH
Wet etch process.
Dry(ICP) etch process.
mems product MEMS Applications
- MEMS Structure
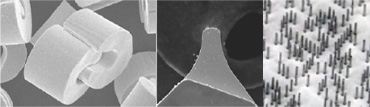
- Ceramic substrate
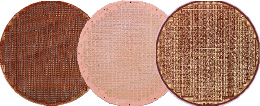
- MEMS Component

mems technology
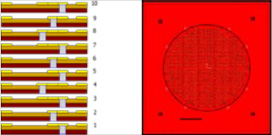
-
Sheet Type Multi-Layer Technology
Multi-layer simultaneous production
Channel sharing with multi-layer wiring
Enables high para probe card sharing with multi-layer wiring
Improved flatness of multi-layer
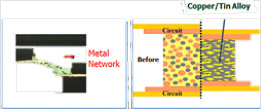
-
Interconnect Technology
Interconnect Technology with Conductive Ink
Electrical Connection by metal sintering

-
MEMS Thin Film Technology
Small Size Via : ≥ 15um
C4 Pad Pitch : ≥ 30um

-
VPC Probe Technology
Low Contact Force : 1.45gf (@Force at OD 75um)
High CCC : 1,500mA (@ISMI)
Available Pitch : ≥ 50um
Long life cycle : ≥ 1,000,000TD

-
MEMS Probe Design and Fab. Technology
High reliability performance with new Ni alloy plating technology
MEMS Vertical Structure
Various probe solution for Cu-Pillar Bumps & BGA
High Aspect Ratio : 6.5:1

-
Stack-up Technology
Guaranteed thermal reliability : No Crack, No Delamination
(@TSCT, Reflow, Floating)Stable electrical characteristic : Resistance change within ±10%
(@Bare Board Test)
TOP